

每个电子应用电路系统都面临着其独特的挑战。大至汽车和,小至可穿戴设备,如何解决热特性问题都变得越来越重要。随着我们在越来越小的空间中集成越来越多的功能,如何确保充分散热已经成为关键问题所在。(半导体)的 DFN 封装产品组合为解决热失控问题提供了很好的解决方案。
功耗、散热一直以来都是设计工程师而不得不面对的一个难题。在过去,这个问题相对容易解决,只需要在芯片或电路板上连接一个高效即可。但是,随着电子设备尺寸不断缩小,运行速度越来越快,电路板密度越来越高,半导体芯片温度也随之升高。工作环境温度的恶化很容易使问题加剧。
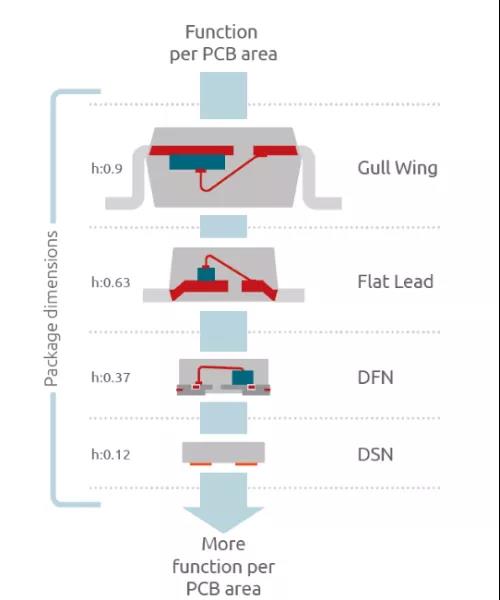
正如我在“让汽车行业轻松转入无引脚时代”这篇博客中所述,采用小尺寸分立式的扁平无引脚 (DFN) 封装可以释放大量电路板空间。这样设计工程师就可以缩减总体占位面积,或者在同一块电路板上集成更多功能,同时保持 DFN 封装采用了 SWF 这种可焊性侧面的工艺,方便了光学检测 (AOI) 。重要的是,它还为设计工程师提供了一种相比与传统封装,热性能更加优越的封装解决方案。
通过对比相同设备分别采用 和 DFN 的结果,我们发现电气参数几乎相同。毫无疑问,DFN 封装通过删除引脚,改善了寄生和电感。不仅如此,DFN 封装还可显著提高了热性能。这一点在热模拟中得到明确证明,例如在以下示例中,对分立式半导体器件应用了相当于250 mW 内部耗散功率的偏置条件。
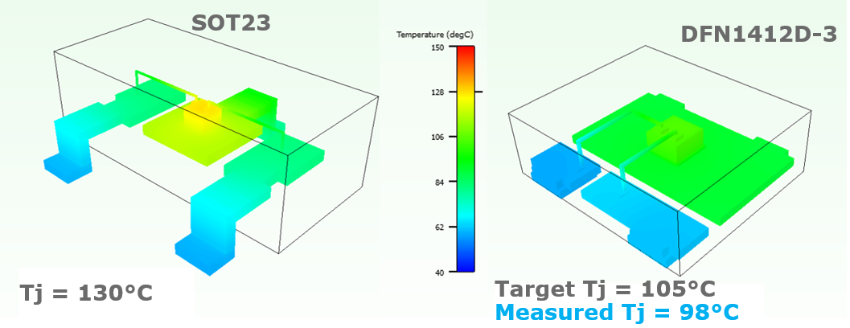
△ SOT23 与 DFN 1412D-3热模拟,内部耗散功率为250 mW。
在SOT23 封装中,硅芯片内部产生的热量需要通过引脚传导到 PCB 从而达到热耗散。PCB 和塑料封装引脚和芯片本体将热量以辐射的方式散发到周围环境中。在该模拟中,我们假设环境温度为 25 ℃, 中的硅温度升至 130 ℃。
而在 DFN 中,热量从硅通过内置金属散热器直接散发到 PCB。在上述模拟中,DFN 1412D-3 封装内部温度保持在105 ℃,这与硅温相差了 25 ℃。事实上,测得的结果表明,结温只有 98 ℃。显而易见,DFN 封装的热连接明显优于 。
这一硅温差非常重要。一方面,我们可以进一步提高这类封装的功率密度。换言之,设备可以在正常工作模式下以更低温度运行。这有助于延长设备的使用寿命,从而提高系统可靠性。